Что такое упаковка микрочипов и зачем она нужна?
Чтобы превратить кремниевый диск в пачку процессоров недостаточно просто нарезать их на станке…
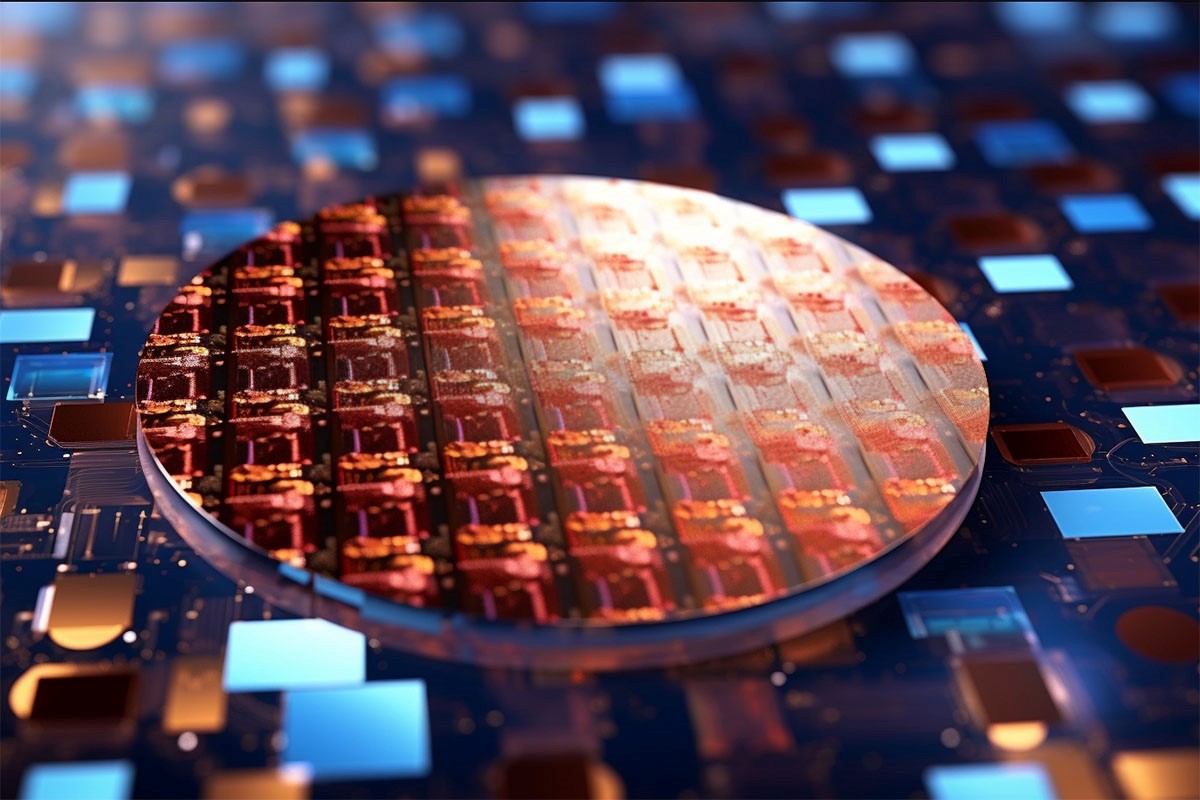
Разработка и производство революционного полупроводника — зачастую лишь первый шаг на пути к созданию рабочего микрочипа. Чтобы превратить полупроводники в компоненты электронных модулей, их необходимо как можно безопаснее, эффективнее и экономичнее «упаковать».
Человек, который хоть раз читал что-то о полупроводниках, наверняка видел фотографию больших кремниевых дисков, содержащих сотни будущих чипов. Однако нельзя просто разрезать эти чипы по шаблону и сразу подключить к печатной плате. Сначала они должны быть упакованы в материалы, которые обеспечивают их безопасность, надёжность и позволяют эффективно пропускать через них электричество.
«Это способ взаимодействия чипа с остальным миром», — сказал Дейл Макхеррон, главный стратег IBM по чиплетам и передовым исследованиям упаковки. «В результате процесса упаковки получается готовый чиповый модуль».
Поскольку на протяжении многих лет компьютерные чипы продолжали уменьшаться в размерах, в связи с чем уменьшался и их технологический процесс, теперь требуются дополнительные исследования, чтобы продолжить упаковывать их как можно эффективнее.
В упаковочном процессе существует две всеобъемлющие области для исследований: материалы, используемые для размещения чипов, и то, как именно эти материалы обрабатываются для создания полноценных чиповых модулей. В этой статье мы разберём и то, и другое.
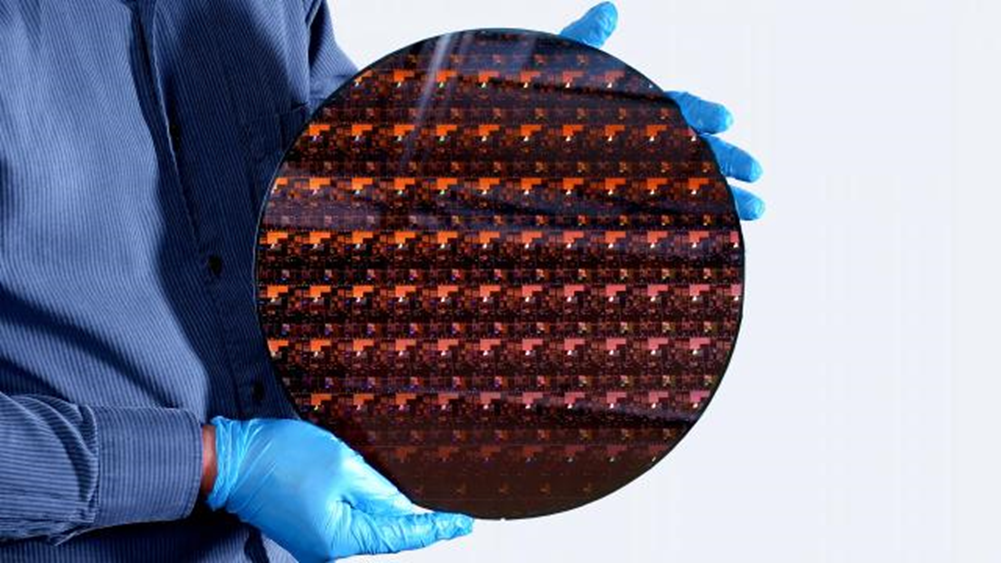
Исследование материалов для упаковки чипов
В двух словах, упаковка обеспечивает механическую среду, в которой работает компьютерный чип. Упаковка позволяет запитать чип и вместить входные и выходные данные, позволяющие ему взаимодействовать с остальной вычислительной системой.
Чипы также имеют тенденцию нагреваться во время работы, поэтому ещё одной целью упаковки является поддержание определённого температурного диапазона, чтобы чип не перегревался и не сокращал ресурс своей работы.
Многие современные микроэлектронные модули изготавливаются примерно из одних и тех же материалов, называемых органическими подложками. После десятилетий проб и ошибок по всей отрасли основным материалом для большинства из них является материал под названием FR-4, который состоит из сплетённого стекловолокна и эпоксидной смолы, которая также является огнестойкой.
Панель FR-4 часто ламинируется тонким слоем медной фольги, материалом с высокой электропроводимостью. В настоящее время ведутся исследования по изучению других материалов для упаковки чипов, таких как сердечники из стекла, которые могли бы обеспечить гораздо более быструю передачу данных и меньшие размеры конструкций чипов. Но до начала упаковки чипов по этим новым технологиям, вероятно, пройдёт ещё много лет.
Чип крепится к органической подложке с помощью шариков припоя, называемых соединениями чипов с контролируемым сжатием (controlled-collapse chip connection или C4). Затем для изоляции шариков используется жидкий эпоксидный наполнитель.
Поскольку чипы продолжают уменьшаться в размерах, необходимо уже сейчас искать новые эффективные способы соединения деталей вместе, ведь припой, используемый в настоящее время в шариках C4, не может эффективно сжиматься так же, как и другие части чипа.
В настоящий момент существуют весьма инновационные методы, такие как гибридное соединение, при котором слои меди и оксидного диэлектрика используются для непосредственного соединения чипов друг с другом без промежуточного соединения припоем. Однако с внедрением инноваций стоит проявлять осторожность, так как при уменьшении масштабов производства необходимо обеспечить чрезвычайно высокий уровень надёжности всех компонентов.
Нагрузки на различные конструкции могут меняться по мере их уменьшения. А с новыми достижениями в области вычислений с использованием искусственного интеллекта и новыми формами конструкций чипов вновь возникает потребность в большем количестве взаимосвязей между чипами для поддержки мощных моделей обучения ИИ и формирования логических выводов.
Большинство исследований в области упаковки сейчас сосредоточены главным образом на повышении надёжности и уменьшении размеров медных проводов и толщины диэлектрика, необходимых для создания высокоплотных соединений между чипами.
Для проектирования, сборки и тестирования компонентов столь крохотных размеров исследуются новые технологические процессы, что включает в себя стресс-тестирование устройств и контроль того, чтобы они могли обеспечивать уровень сигнала и ток, необходимые даже в самых экстремальных рабочих ситуациях.
Детали подвергаются термоциклированию, гарантирующему, что они могут работать при различных уровнях температуры и влажности, а также ускоренному тестированию, которое имитирует многолетний срок службы модуля всего за несколько недель.
Исследование способов упаковки чиплетов
Помимо традиционных структур чипов, современные исследователи также изучают новые способы физического воплощения в жизнь возможностей искусственного интеллекта и других передовых технологий.
Одна из ключевых проблем в мире полупроводников заключается в том, как аппаратно разделить различные функции системы на кристалле, чтобы каждая из них выполнялась наиболее эффективно. Здесь на помощь и приходят чиплеты.
Эти крошечные устройства могут открыть новые возможности при их совместном расположении в рамках одного модуля для выполнения разных задач. Таким образом можно создать эффективный набор, который подойдёт для создания самых передовых и мощных чипов.
На данный момент нет единой стандартизации того, как чиплеты, производимые разными компаниями, будут взаимодействовать друг с другом в рамках одного чипа, хотя работы в этом направлении уже активно ведутся.
Исследование производственного процесса
После того, как новые полупроводники разработаны и протестированы в упаковках, их производство необходимо наладить в больших масштабах. Здесь также необходимо проводить исследования и тестирование, чтобы гарантировать, что конструкции, работающие в лаборатории, легко изготавливаются в том масштабе, в котором они нужны заказчикам.
Данный процесс отладки производства обычно занимает от шести месяцев до двух лет. За это время инженеры и технические специалисты работают над созданием производственных процессов, наиболее подходящих для проекта, с которым они работают, поставляя заказчику прототипы и получая обратную связь для достижения наилучшего конечного результата.
Зачастую может потребоваться протестировать три-четыре итерации производственного процесса, прежде чем все стороны будут довольны его надёжностью и экономической эффективностью.
Когда производственный процесс окончательно выбран, исследователи дополнительно проводят стресс-тестирование всех его подпроцессов, чтобы убедиться, что они действительно могут производить упакованные чипы с высоким уровнем надёжности.
Заключение
Таким образом, упаковка в настоящее время играет гораздо большую роль в проектировании чипов и их производительности, чем это было ещё несколько лет назад.
Несмотря на впечатляющие достижения последних десятилетий, при текущих темпах миниатюризации уже в обозримом будущем исследователи могут столкнуться с фундаментальными физическими ограничениями. Поэтому помимо улучшения существующих подходов крайне необходимо вести поиск принципиально новых решений для дальнейшего прогресса отрасли.
В тех немногочисленных исследованиях, что уже ведутся сейчас, учёные стараются найти замену традиционным материалам, оптимизировать расположение и соединение чиплетов внутри корпуса, а также выработать более технологичные и надёжные производственные решения.
От успеха этих разработок будет зависеть прогресс всей отрасли, включая доступность для широкого применения таких перспективных направлений, как искусственный интеллект и интернет вещей.

